この記事で学べること
- ATPG の目的と背景
- 故障モデル・テストパターン・可観測性/可制御性などの基本概念
- DFT(Design for Testability)との関係
- 実務での利用シーン(スキャン設計、故障解析、歩留まり改善など)
- 誤解しやすいポイントと注意点
- 関連用語の体系的整理
概要
ATPG(Automatic Test Pattern Generation)は、半導体デバイスの製造テストに用いるテストパターンを自動生成する技術です。主に スキャン設計(Scan Design) と組み合わせて利用され、故障モデルに基づいて「故障を検出できる入力パターン」を生成します。
ATPG の役割は、以下の 3 点に集約できます。
- 故障を検出するためのテストパターンを生成する
- テスト品質(Fault Coverage)を最大化する
- テスト時間・テストコストを最適化する
ATPG は、現代の SoC 開発において不可欠な DFT フローの中心技術です。
なぜ重要なのか
半導体の微細化・複雑化に伴い、以下の課題が顕著になっています。
- 製造欠陥の増加
- 回路規模の巨大化による手動テスト生成の不可能性
- テスト時間の増大によるコスト増
- 高品質テスト(低 DPPM)が求められる市場要求
ATPG はこれらの課題に対して、
- 故障を効率的に検出するパターンを自動生成し
- テスト品質を保証し
- テストコストを抑える
という役割を果たします。
基本概念の整理
故障モデル(Fault Model)
回路に発生し得る故障を抽象化したモデル
例:Stuck-at Fault(SA0/SA1)、Transition Fault、Path Delay Fault
実務での意味:ATPG が「どの故障を検出すべきか」を定義する基準
可制御性(Controllability)・可観測性(Observability)
可制御性:内部ノードを特定の値に設定しやすい度合い
可観測性:内部ノードの値を出力で観測しやすい度合い
例:深い論理階層の信号は可観測性が低い
実務での意味:ATPG の成功率やパターン数に直結するため、DFT で改善する
スキャン設計(Scan Design)
フリップフロップをシフトレジスタとして連結し、内部状態を制御・観測可能にする設計手法
例:Scan FF、Scan Chain
実務での意味:ATPG の前提となる DFT 技術。スキャンがなければ実用的な ATPG は成立しない
テストパターン(Test Pattern)
故障を検出するための入力ベクトルの集合
例:Scan-in → Capture → Scan-out のシーケンス
実務での意味:ATE(自動テスタ)で実際に適用されるデータ
Fault Coverage(故障検出率)
対象故障のうち、テストで検出できる割合
例:Stuck-at Coverage 99%
実務での意味:品質指標として顧客・製造部門が重視する
実務での具体的な利用シーン
スキャン挿入後の ATPG パターン生成
- DFT ツールでスキャン挿入
- ATPG ツールで故障モデルに基づきパターン生成
- Fault Coverage を評価し、必要に応じて DFT を改善
量産テスト(ATE)での利用
- 生成したパターンを ATE にロード
- Scan-in → Capture → Scan-out を繰り返し、故障を検出
- 歩留まり改善や不良解析に活用
設計段階での品質保証
- 早期に Fault Coverage を確認し、設計品質を評価
- DFT の不足箇所を特定し、改善サイクルを回す
不良解析(Failure Analysis)
- 特定の故障を検出するパターンを生成し、物理解析の効率を向上
誤解しやすい点・注意点
「ATPG は万能ではない」
- すべての故障を検出できるわけではない
- DFT の品質が低いとパターン生成が困難になる
「Fault Coverage が高い=品質が高い」ではない
- モデル化されていない故障は検出できない
- Delay Fault や Cell-aware ATPG など、多様なモデルが必要
「パターン数が多いほど良い」わけではない
- ATE のテスト時間が増加し、コストが上昇
- 圧縮技術(Test Compression)が必須
ATPG の全体フロー(DFT との関係)
関連する専門用語の整理
| 用語 | 説明 | 実務での意味 |
|---|---|---|
| ATPG | 故障検出パターンを自動生成する技術 | テスト品質とコストを左右する中心技術 |
| Fault Model | 故障を抽象化したモデル | ATPG の対象範囲を決める |
| Stuck-at Fault | ノードが 0/1 に固定される故障モデル | 最も基本的なテスト対象 |
| Transition Fault | 遷移が遅延する故障モデル | タイミング不良の検出に重要 |
| Scan Chain | FF を直列に接続した構造 | 内部状態の制御・観測を可能にする |
| Fault Coverage | 故障検出率 | テスト品質の指標 |
| Test Compression | パターン数を削減する技術 | テスト時間・コスト削減 |
| ATE | 自動テスト装置 | 量産テストでパターンを適用する装置 |
まとめ
- ATPG は 故障検出パターンを自動生成する技術であり、DFT フローの中心に位置する
- スキャン設計と故障モデルが ATPG の前提
- 可制御性・可観測性がパターン生成効率を左右する
- Fault Coverage は重要だが、万能ではない
- 実務では、テスト時間・コスト・品質のバランスが鍵
- ATPG は製造テストだけでなく、設計品質評価や不良解析にも活用される
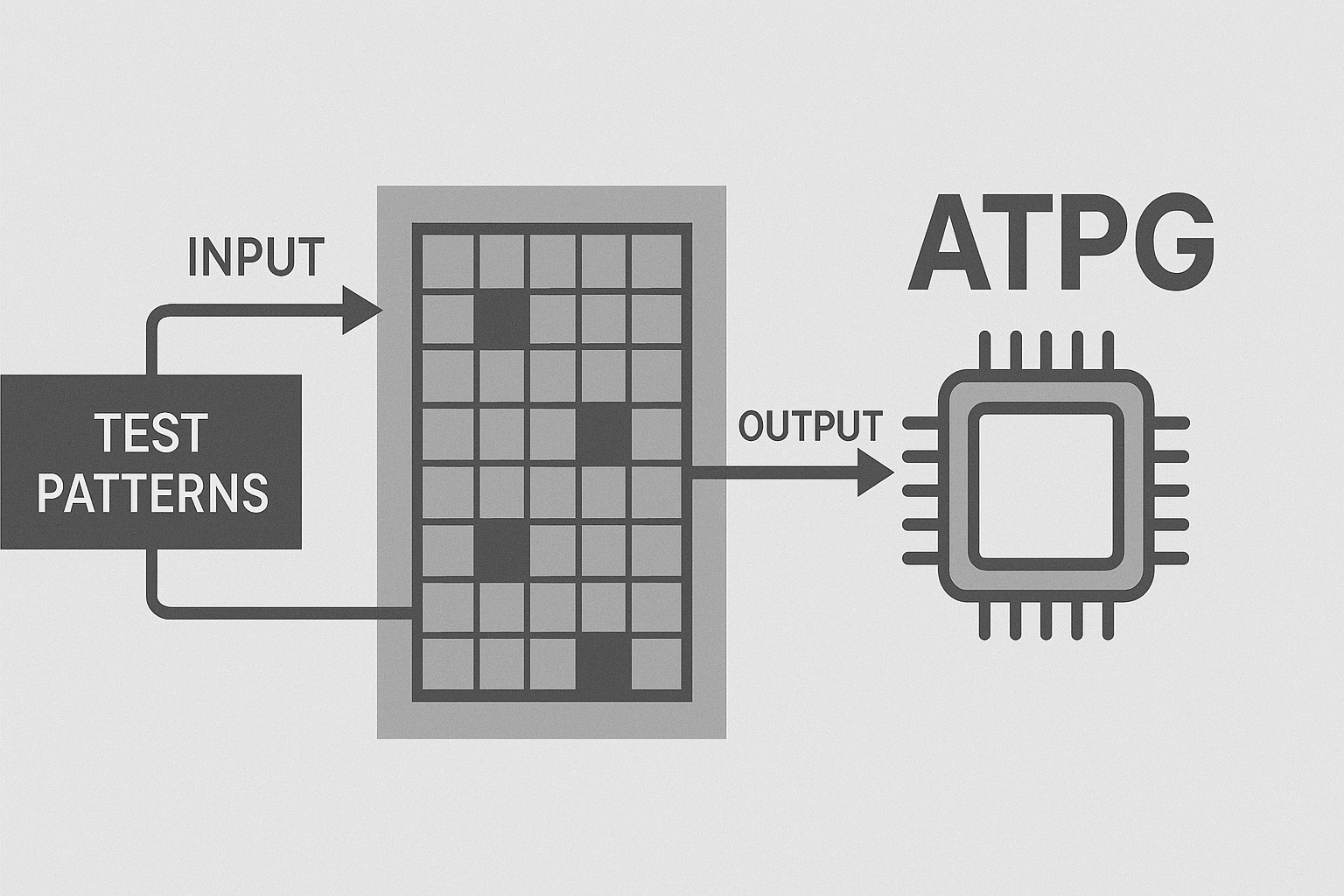

コメント